 通过考特尼加纳,马2019年7月18日
通过考特尼加纳,马2019年7月18日
KLA公司(纳斯达克:KLAC)宣布了392x和295x光学缺陷检测系统以及eDR7380™ 电子束缺陷审查系统。
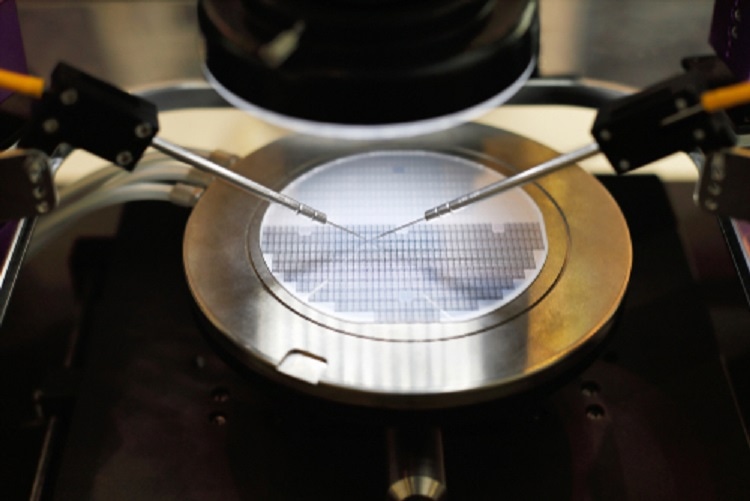
图片致谢:Genkur / shutterstock.com
新的检测系统是该公司旗舰图案晶圆平台的延伸,具有定义光学检测的速度和灵敏度方面的进步。新的电子束审查系统引入了一些创新,巩固了其作为缺陷和源头之间的重要联系的价值。该产品组合旨在加快领先的3D NAND、DRAM和逻辑集成电路(IC)在其整个产品生命周期中的上市时间。
“下一代存储和逻辑芯片的生产要有利可图,需要前所未有的过程控制。设备结构更小、更窄、更高、更深,具有更复杂的形状和新材料。亚博网站下载区分缺陷和良性的物理变化——信号和噪声——已经成为一个难以置信的难题。我很高兴地宣布,我们的光学和电子束工程团队已经开发了一系列创新的、连接的缺陷检查和审查系统,旨在使我们的行业继续向前发展。”
艾哈迈德·汗,KLA全球产品集团执行副总裁。
392x和295x光学图案晶圆缺陷检测系统通过利用宽带等离子体照明技术、传感器体系结构和芯片设计信息集成方面的重大进步,实现了无与伦比的灵敏度、吞吐量和产量相关装箱。因此,与业界领先的前辈相比,新系统提供了更快的缺陷发现、更快的产量学习和更全面的在线监控。392x和295x系统使用不同的波长范围来覆盖所有层的检查应用,从浅沟隔离到金属化,包括EUV光刻质量控制。
eDR7380电子束晶圆缺陷评审系统具有一流的图像质量和在一次测试中交付完整缺陷pareto的独特能力,在开发过程中提供更快的缺陷来源,更快的偏差检测,以及更准确、可操作的生产数据。该系统可支持脆弱的EUV光刻工艺层的审查。与KLA检验员的独特连接减少了得到结果的时间,能够访问广泛的特定于KLA的应用,并通过智能取样和有效的缺陷数据交换提高了检测灵敏度。
392x, 295x和eDR7380系统可作为新系统或从上一代39xx, 29xx或eDR7xxx系统升级。这些系统是为将来的可扩展性而设计的,以保护工厂的资本投资。
所有的新系统都在全球领先的集成电路制造商中运行,他们共同努力使创新的电子设备可制造。为了保持芯片制造商要求的高性能和生产力,392x, 295x和eDR7380系统的支持KLA的全球综合服务网络.关于新的缺陷检查和评审系统的更多信息可以在组合信息页面.