IMEC介绍电电和集成技术及其集成方法的创新22nm互连化、Cu/low-k可靠性评估以及抑制低k集成损方面大有进展结果有助于提供32nm节点以外的互连性能和可靠性
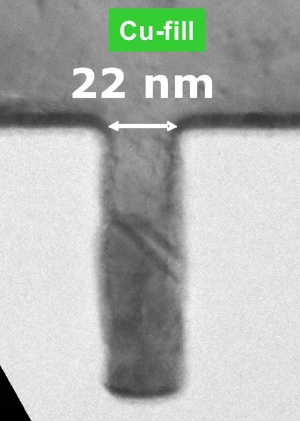
高级集成
IMEC研究者调查RuTa解析计划,认为这是一个有希望实现22nm特征佳解析计划有可能取代传统Ta物理蒸发沉降物(PVD),该沉降物因特征大小下降而松散实现划一Cu种子的能力四种不同的计算方法(即TaN/Ta、RuTa、TaN+Co和MnOx)从Cu填充量、电性能和与化学机械打滑相容性学角度评价图1
屏障电磁可靠性评估
IMEC开发出模型首次描述线边粗度和时间依存二电分解存模型对嵌入k=2.5低k材料的50nm半点Cudamascene线验证,显示LER大有助于综合二电可靠性差分变分对老式技术节点而言,可靠性主要取决于二电沉降、模式设计(lithscript/ash)、屏蔽沉降、CMP和ap沉降,而对于22nm及以后LER撞击预期会增加
IMEC研究者还研究Cu互连入多孔低k和airgap结构亚博网站下载高孔径材料的主要趋势是Cu压力较低,对窄线效果不大空隙结构显示最小应力这项工作有助于解释可靠性失效机制并校准有限元素模型预测设备未来技术节点的压力
IMEC展示了一种独特的测试工具评估铜低k互连并成功使用它排列不同技术选项的内在可靠性方面测试结构还适合研究屏障/低k界面、低k等离子处理器、净化器等使用测试器预期会对整个互连社区做出重大贡献,识别并描述铜/低k集成基本可靠性限值
Plasma诱导低k损耗减少
IMEC建议非接触电常量计基于近场扫描探针微波显微镜评价二电处理步骤后特性技术用于研究等离散灰化去除光阻掩码效果,并证明是非侵入式实时线内监控内接分接分解过程的每一步低k结构的好方法亚博网站下载Plasma损耗是Cu/Low-k集成期间低k材料二电可靠性损失的主要原因亚博网站下载引入多孔低k材料提高了电介对等离子体损耗的敏感度
IMEC开发替代非plasma线路消除光电阻而不攻击低k素材方面也取得了良好进展特别吸引人的方法是全湿清除法,因为它能减轻干灰造成的损害方法中V预处理O3和溶剂处理已完全清除后金属硬纹照相外基阴离子O3和气体扩充液化过程显示有希望后拉残余消除
与IMEC核心程序关键分析者合作获取这些结果:英特尔、微信、Panasonic、三星、TSMC、Elpida、Hynix、Powerchip、Infineon、NXP、Qualcomm、Sony和ST微电子