100 PlasmaPro RIE模块从牛津仪器帮助实现各向同性和各向异性广泛的干法蚀刻过程。这些模块是理想的研究和生产的客户,提供一个环境,提高过程控制重复性装载和盒对盒选项。
- 兼容所有晶片尺寸200毫米不等
- 快速改变晶片大小之间
- 杰出的均匀性、高吞吐量和高精度的过程
- 宽温度范围内电极,从−150°C到400°C
- 现场室清洁和端点
- 单晶片或批处理与杰出的过程控制
- 高气体和等离子体的控制权力
- 简单的可服务性和低拥有成本
概述
反应离子刻蚀(RIE)是一个物理腐蚀过程。取得了丰富的等离子体的晶片,和离子加速向表面生成一个非常强大的各向异性腐蚀。
使用wafer-level射频源,气体渗透室的顶部,它转化为活性等离子体在低压力。离子与样品开发蚀刻副产品或保持未反应的物种。所有的未反应的物种和副产品由真空泵从商会保持丰富和活跃的等离子体来维持高腐蚀率。
100 PlasmaPro RIE给基质活性物种,甚至拥有一个高电导路径通过室,从而使高气流被利用,而低压保留。
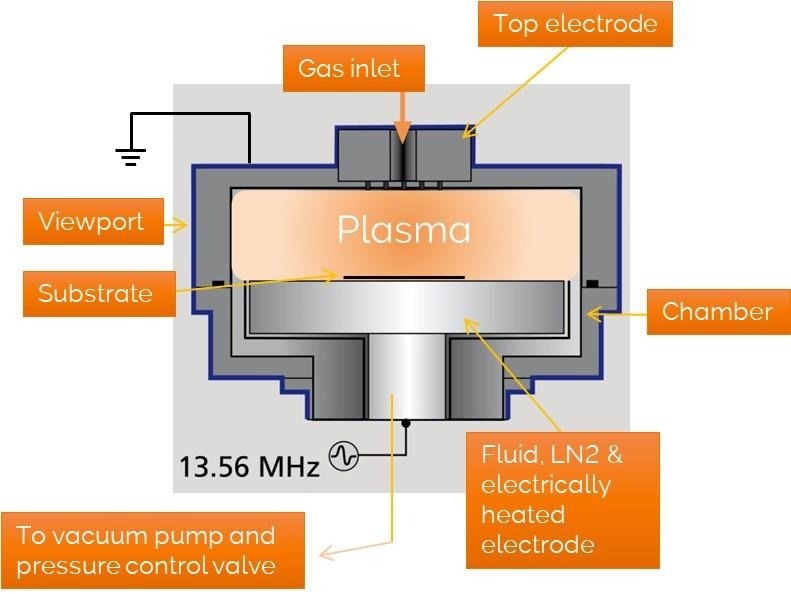
图片来源:牛津仪器等离子体技术
特性
- 宽温度范围内电极(-150°C + 400°C),可以使用液态氮冷却,油烟流体冷却器或电阻加热。一个可选的吹出和流体交换单元的过程可以自动化切换模式
- 高泵送能力给出了宽过程压力窗口
- fluid-controlled电极是由循环冷却装置,并提供优秀的衬底温度控制
- 单引号或双磁带可用各种处理程序选项
- 活性物种衬底的一个统一的高电导路径通过室
- 晶片夹紧他为最佳晶圆背面冷却温度控制
- 选择一个高度可靠的真空转移机器人
应用程序
- 固态激光可使腐蚀
- III-V腐蚀过程
- VCSEL砷化镓/ AlGaAs腐蚀
- 射频设备低损害GaN腐蚀
- SiO2和石英腐蚀
- 铝、铬、钛等金属
- 聚合物和光阻
- 类金刚石碳(DLC)沉积
- 芯片失效分析干蚀刻de-processing从包装和死亡通过满200 mm晶圆腐蚀腐蚀
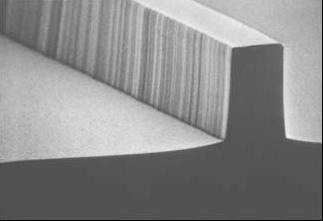
的RIE InP波导。图片来源:牛津仪器等离子体技术
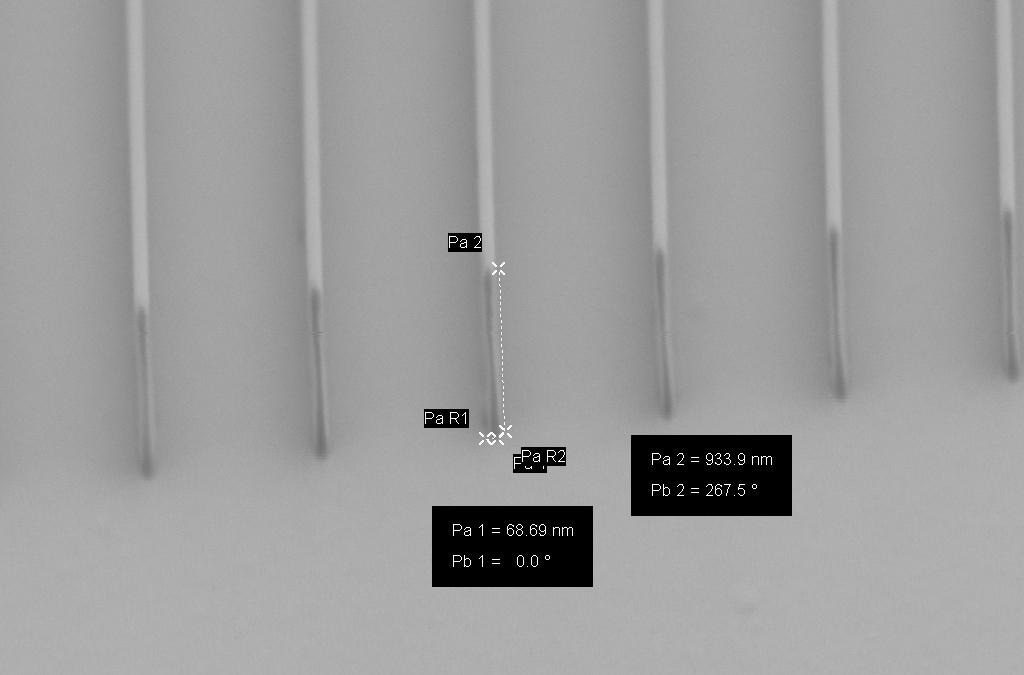
70纳米石英线933海里深Cr面具。图片来源:由康奈尔大学纳米科学设施。亚博老虎机网登录
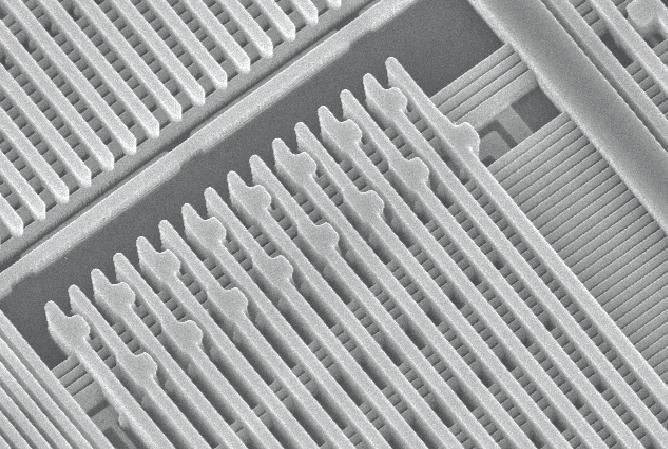
金属腐蚀介质。图片来源:Atmel的礼貌
规范
集群负载锁选项
- 可集群高达4 *过程模块,包括退化、ICP、啤酒、PECVD, " CVD、离子束刻蚀,离子束沉积系统
- 单一晶片直接加载到中央处理单元或通过一个可选的负载站(穿过墙壁所需集成)
- 可以在同时操作多个室处理晶片等待室,直到负载站在真空和空的
*与MX600ss
典型的条件
- 5 - 500毫托操作压力
- 5 - 200 sccm总气体流
- 30 - 800 V直流偏压电极上生成低
- 0.1 - -1.5 W /厘米2功率密度
- 底物通常位于一个石英或石墨盖板
高级负载锁选项
- 开放:前由气体struts和锁定机制
- 手臂位置控制:步进电机
- 晶片跟踪:是的
- 维度:紧凑的变暗。+ 80毫米宽,90毫米长。更适合200 mm晶圆
- 推荐:位置精度是应用的关键
- 不推荐:透明基板