在半导体器件中用于产生电连接的大部分金属痕迹开始时都是覆盖层金属薄膜,后来经过图案和蚀刻,在器件元件之间形成导电连接。

R50四点探针接近导电层的表面。图片来源:KLA Instruments
为了最大限度地提高器件性能,晶圆在薄膜金属厚度和薄片电阻方面的均匀性至关重要。这篇文章概述了KLA Instruments™Filmetrics®R50用于金属膜测量的四点探针和涡流(EC)技术,以及讨论如何将R50薄层电阻图转换为膜厚度图。
四探针测量技术
4PP技术已经被使用了一个多世纪,由于其准确性和简单性而保持流行。在四点探针设计中,电流在与导电表面接触的两个引脚之间传输,同时电压在与导电表面接触的另外两个引脚之间测量,如图1所示。
通常,引脚的排列是一个正方形或线性阵列,本文的讨论集中在R50探针使用的线性阵列。
大部分的应用,传统的测量配置(图1(左),但是另一种配置(图1右)可以用于测量的R50双重配置方法在当前的情况下聚集在影片的边缘,或修正针间距变化。这里详细介绍的测量结果仅使用了标准配置。
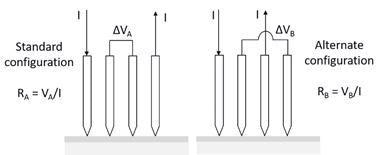
图1所示。标准(左)和备选(右)线性配置的四点探针引脚原理图。备用配置被用作R50双配置测量方法的一部分,该方法通常用于薄膜边缘的电流拥挤或当针间距变化需要校正的情况。图片来源:KLA Instruments
涡流测量技术
EC技术测量通过施加的交变磁场在导电层中产生的涡流量,如图2所示。通过线圈的时变驱动电流在线圈周围产生时变的主磁场。
当探头线圈靠近导电表面时,导电材料内部会产生时变(涡流)电流。这些涡流产生它们自己的时变二次磁场,与线圈配对,产生信号相对于样品的薄片电阻的变化。
增加层内电导率的直接结果是更大的涡流感应和更大的驱动线圈的实阻抗和虚阻抗的变化。
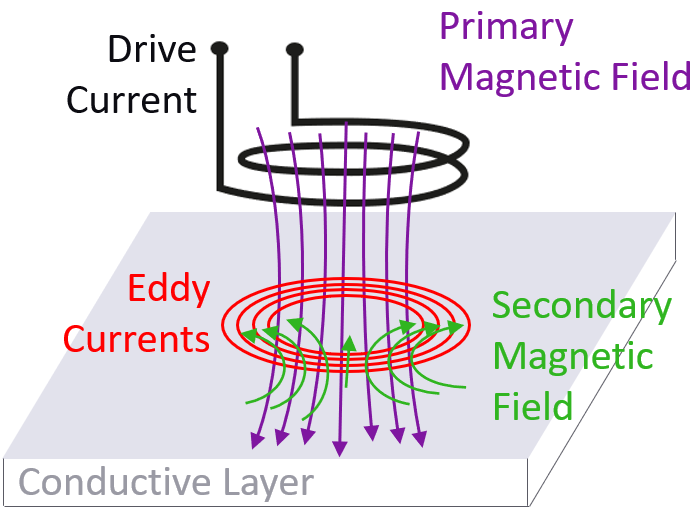
图2。涡电流(EC)技术通过线圈产生时变电流,该线圈在导电层中产生时间变化的涡流。这些时间变化涡流反过来产生一种磁场,该磁场改变驱动线圈的阻抗,这与层的薄层电阻成反比。图片来源:KLA Instruments
R50薄板电阻数据分析和可视化
什么时候4PP或EC测量,并计算板电阻(Rs), R50数据对每一种方法进行类似的管理。根据用户的喜好,可以直接输出薄片电阻值,或者利用RsMapper软件中的转换功能将数据更改为薄膜厚度:
Rs =ρ/ t
其中ρ是电阻率,T是膜厚度。
图3中的图像显示了2μm标称厚度铝膜的薄层电阻图和膜厚度图。从薄层电阻数据(图3,左),使用标称电阻率(图3,中心),将数据转换为膜厚度的地图(图3,右)。
在胶片厚度图中展示数据可以更适合和视觉上的许多应用程序。
RsMapper软件还提供了差异图,其中来自两个特定晶圆的数据被绘制成一个单独的图,显示它们之间的差异。这一特性对于评估蚀刻或抛光过程前后的片材电阻特别有用。
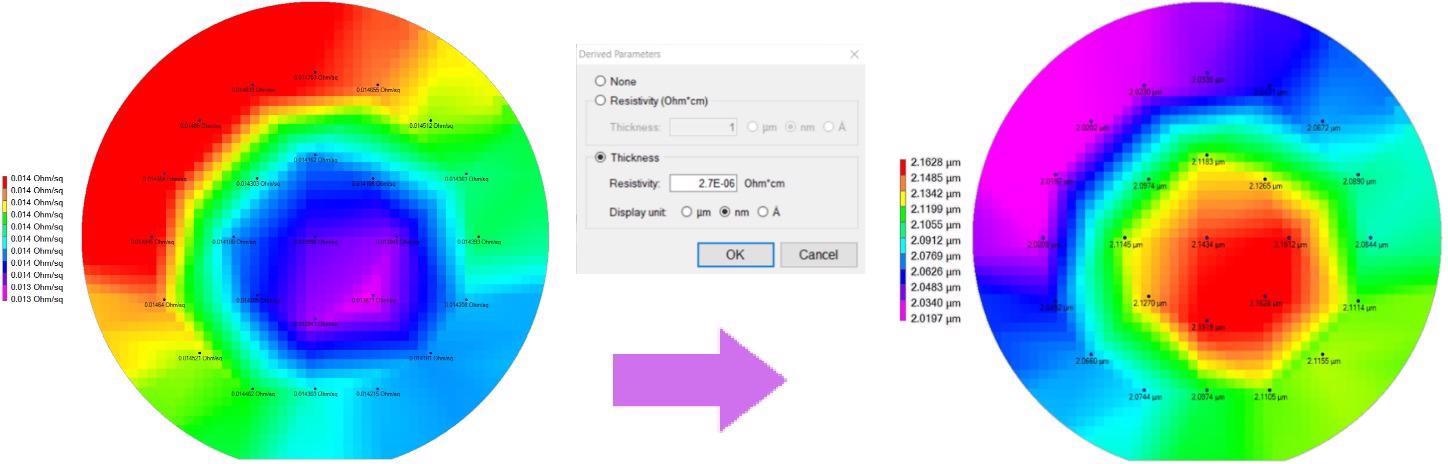
图3。图中有一个厚为2µm的铝层用于表阻(左)。RsMapper软件可以通过薄膜厚度的推导(中)来生成导出的薄膜厚度图(右)。厚度图显示出一个偏心丘,这可能是由于沉积体系中的偏移。其他可能的原因包括晶圆与金属目标的不对齐或晶圆的轻微倾斜,这也会产生类似的图案。图片来源:KLA Instruments
选择合适的技巧
R50-4PP的最大片阻为200 MΩ/sq。这使得它成为最薄的金属薄膜的完美选择。对于极厚的金属薄膜,电压降(图1中引脚2和引脚3之间)表现为异常小。
实际上,这限制了4PP技术对测量金属膜不超过几微米的能力,这取决于金属的电阻率。
对于薄层电阻测量,由于极薄的金属膜产生的最小涡流,EC方法限制为不小于约100nm的金属厚度(或约10Ω/ sq。。
这种限制部分是由于R50-EC的光斑非常小。
在可以使用4PP和EC技术的范围内,通过与样品接触的销可以防止一个确定因子可以防止损坏或污染。推荐EC技术用于这些类型的敏感表面。
如果要测量的薄膜在可能产生额外的涡流的导电基板上,则建议使用4PP技术,假设绝缘层阻挡4PP DC电流。
其他金属薄膜的应用
有许多应用需要测量掩埋或背面金属层。对于掩埋层,在4PP和导电层之间阻抗接触的任何非导电层将使4PP技术无效。
当埋设层电阻< 10 Ω/sq时,可以用EC测量埋设层。
关于背面应用,如果样品可以在压板上定位在压板上,则可以使用4PP测量该层。如果不可能,则EC技术通常可以通过面向上样本来测量以区分后侧金属层。
结论
的Filmetrics R50系列促进测量各种金属层,R50-4PP建议在较薄的薄膜上用于较薄的膜,由于它们的较大抗性和4pp的广泛测量范围。
R50-EC建议用于极厚的薄膜,或用于柔性/柔软和/或敏感膜,其中需要非接触测量。大的有效采样间隙还意味着除了晶片或薄的扁平基板之外,R50还可以在宽范围的样品尺寸上使用。
对于薄膜应用,KLA Instruments集团提供额外的解决方案,如Filmetrics系列台式和自动化工具,用于测量薄膜厚度和折射率。
KLA Instruments纳米压痕系统提供薄膜材料性能的测量和测绘,有助于表征断裂韧性、划痕和耐磨性。手写轮廓仪和光学轮廓仪也可用于薄膜台阶高度测量。

图片来源:KLA Instruments

此信息已采购,从KLA Instruments™提供的材料进行审核和调整。亚博网站下载
有关此来源的更多信息,请访问解放军™工具。