几个兆元正在塑造当代数字社会,而这些既然正在推动半导体制造的光学图案化设备的连续发展和扩展能力。app亚博体育
2D-IC密度缩放开始达到其成本限制,特别是在图案化过程的情况下。随着这些限制的达到,小型化和装置性能的进步继续朝向3D集成先进包装内的异质集成(HI)。
这种新方法被认为是下一代设备的发展中的核心因素,从而在移动处理器的出现时提示了3D / HI中的初始增长周期。预计这一增长周期将继续作为5G和人工智能(AI)的高性能应用(AI)在移动设备中变得更加常见。其他驱动程序包括兆元,如自主驾驶和物联网(物联网),两者都需要高可靠性和数据网络容量。
多年来,先进的包装技术已经变得更加复杂和变化,3D集成能够从单一到多模包装转变。这只是解决管理高性能计算生成的大量数据的挑战的一个示例。
Chiplet设计中的持续创新耦合,与无需集成方案(硅,嵌入式或包装上)可以包括多个图案化级别。设计灵活性变得越来越重要,行业现在需要更短的开发周期,以及同时容纳各种先进包装平台的能力。这需要在后端光刻处理期间同时采用模具和晶片级设计。
任何先进的产品设计混合都会增加多个掩蔽水平,这意味着掩模和掩模库存/洁净室存储代表了相当大的整体生产成本。传统激光源或HG灯的替换部件也可能产生高成本。
在传统的基于口罩的生产环境中,新物理口罩集的等待时间和高产品组合设计的复杂新设计概念验证可能会导致开发周期延长。
半导体包装中的这些关键需求促使EVG的屏蔽曝光(MLE™)技术的开发。MLE™技术提供了设计灵活性,同时通过消除消耗成本和掩模相关的困难,同时在开发和生产设施中同时实现独特的可扩展性,降低研发和生产阶段之间的开发周期。
这项新颖的技术提供了高分辨率(<2μm的L / s),无缝合和动态可寻址整个基板表面的曝光,因此可以实现敏捷的加工和确保高额所有权(COO)。
传统曝光方法的局限性
任何光学成像系统的分辨率基本上由曝光波长和其数值孔径(NA)的比率限定。Na通过透镜确定光聚光和发光电位,其特征在于孔径角,因此取决于焦距。
曝光系统中NA的改变技术上比缩短光源的UV波长更具成本效益。像步进者这样的成像曝光系统通常朝向更高的NA驱动,从而能够构成更细的关键尺寸。
相反,更高的NA会降低聚焦深度。因此,在互连电路设计中找到分辨率和焦距之间的平衡是很重要的。这在高级封装中是必不可少的,因为在多晶片解决方案中集成不同晶片制造商的晶片时,晶片的重组是一个核心因素。
除了上述物理局限性,由于由过型模具引起的模具置入和模具变化的变化而产生进一步的困难。目前的光刻踏板和其他基于掩模的系统通常努力管理这些困难。
给定的标线尺寸和光学尺寸的静态曝光系统导致曝光面积的限制。当使用较大的模间插入器制造时,这尤其具有挑战性,因为针线或十字曝光场不匹配的重叠区域有可能对再分布层(RDL)的电性能产生不利影响。
当使用具有高级图形处理、高性能计算(HPC)和人工智能所需的复杂布局的先进设备时,能够为插入器生成一个超过当前网格大小的无缝图案是很重要的。
MLE™通过亚纳米范围的舞台运动精度、基于矢量的掩模文件的实时模式和强大的、无失真的、高强度光学的独特组合,满足了这些需求。其他方法,必须光栅化掩模图像之前的模式将产生大约141 GB的数据,每300毫米晶圆。

图1。关键尺寸与DOF处理窗口评估的重点位置。图片来源:EV Group
数字掩模图案以子μs定时精度投影到基板表面上。这MLE™成像系统是衍射限制的,很像大多数现代镜片。它支持±12μm的深度焦点(DOF)。图1显示了在模拟曲线上以2μmL/ s的DOF处理窗口性能的测量。
由于曝光窗口,相对较小的曝光场和<1μm精确自动对焦,可用动态聚焦范围延伸到超过100μm。由于系统的能力通过卡盘定位和晶片夹紧控制较大晶片位置的焦点位置,可以容易地补偿弯曲和翘曲的基板。
动态曝光方法和主动模移补偿
电流后端光刻系统无法控制小于曝光场的失真。因此,这些系统将以非线性,高阶衬底扭曲和与模切相关的问题斗争,特别是在晶片上的模具重构之后。
为了适应表面变化和基板材料,Mle™利用自动焦点的动态对准模式。高级失真功能涉及来自同步可见或近红外顶部和背面对准的实时数据。它通过主动补偿机械模具放置,基板的高阶扭曲等应力诱导的不准确性,例如旋转,位移和膨胀。

图2。高级失真补偿原理图流程。图片来源:EV Group
图2提供了高级失真校正功能和动态校准模式的流程可视化。动态对齐具有全局和多点晶圆对齐选项,通常可在布局中随机放置多达16个对齐标记(用蓝色和黄色标记)。这使得仪器能够全面覆盖基片上最关键的区域,同时也补偿了全局失真。
一旦完成了未对准测量,将在设计内部插入并实时呈现之前,将在设计之前并行编译位移向量。这些暴露的图案将完全误差补偿,而不会诱导重叠或非覆盖区域,因此确保对图案化过程的吞吐量没有影响的最小未对准。
这里所示的示例呈现了极端非典型未对准之后的补偿布局(深灰色)的可视化(用红色箭头表示)。这是使用动态对准模式补偿多点对齐的16个标记(黄色)的实际位置的结果。
当使用多层和多模加工中常见的粘合的粘合,不透明基板或其他非透明材料时,背面对准将起到相当大的作用。亚博网站下载参考多个曝光的相同结构也将有助于最小化未对准,因为电流模式设计的密度增加。
覆盖错误或任何类型的错位将影响触点和绝缘的电性能,并且这些也可能导致连接故障,显着影响FAB产量,COO和整体生产率。

图3。顶部和底侧对准物镜的示意图。图片来源:EV Group
系统配有MLE™技术通常集成完整的晶片背面对准(图3),采用具有近IR功能和专有卡盘设计的专用目标,以容纳高达300毫米的晶片尺寸。
在使用Fowlp时,晶片上重构后引起的模具畸变误差是典型的。在这些情况下,应在芯片级别应用高级失真功能,具有主动补偿和重新路由结果仅依赖于外部计量数据。
失真补偿算法通常包括刻度,旋转,剪切和转换(移位)的数学校正。在解决模具放置误差补偿时,模型将限制模具内的扭曲到模具的刚体。这通常由每芯片的两个(外部)对准点表示。
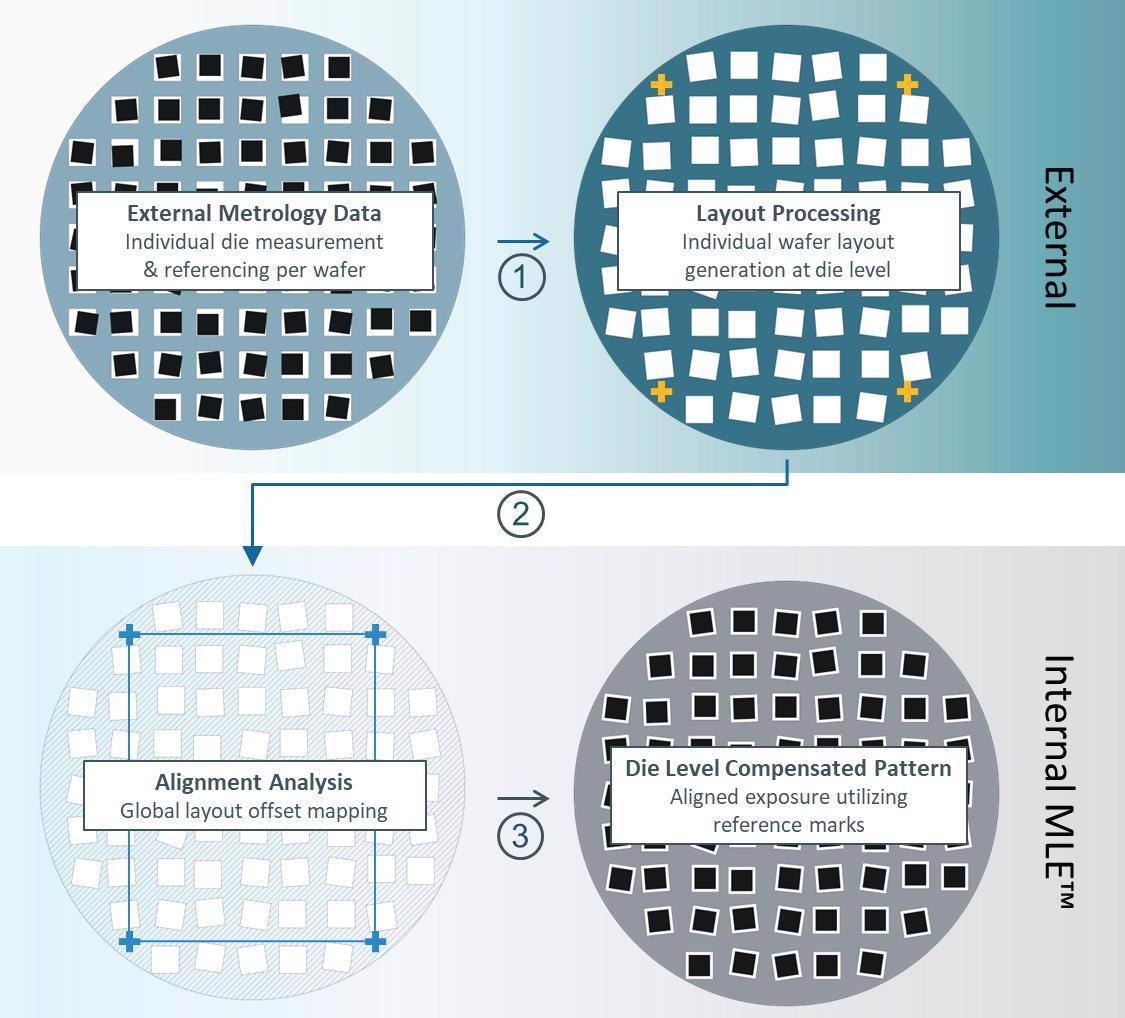
图4。模级补偿原理图过程流程。图片来源:EV Group
转换过程的即时性意味着动态二进制模式生成将补充每个模具的外部获取的计量数据。在曝光之前,这是单独的每个衬底完成的,以便补偿覆盖/定位误差,从处理或预处理不包括潜在的热影响。图4可视化模级补偿的简化数据完整性流。
MLE™图案促进了实时个性化晶圆级布局,同时构建单个模具布局。在使用Ad Hoc Die注释,功能和直接可读的加密代码,序列号,主动保险丝图图案时特别有用,以优化用于处理的设备键,或设备跟踪和文档。这也将最终导致改善总体产量。
在亚像素级可编程的UV剂量调制允许使用曝光梯度。这些用于在显影过程后控制电阻厚度水平的变化,也称为灰度光刻。这种方法有效地促进了复杂的三维多层抗蚀图案的制作,非常适合于多图案工艺,MEMS器件,双大马士革,折射和衍射微光学元件。
数字可编程模具/晶片布局可以存储在一系列行业标准布局设计文件格式中;例如,Gerber,GDSII,OASIS,ODB ++或BMP。由于布局在配方控制下的系统上计算地处理,因此抗蚀剂类型(正/阴性),曝光剂量水平或设计布局复杂性等因素不会影响图案化过程的速度。
副网格的图案化模块化和重要定位
MLE的分辨率使其适用于典型的后端分辨率,具有对辐照线的微量控制,以及它们的间隙(L / S <2μm)。它可以容纳这些分辨率,同时保持CD均匀性(CDU <10%CD)和248 nm图案网格级中存在的任意结构的位置精度。
无扭曲的光学和阶段放置精度有助于确保整个基板的无缝投影。曝光可以用高度灵活的强度控制和精确的光源 - 频谱调谐进行。这些因素允许用户在使用各种市售和新的光致抗蚀剂时实现最佳吸收和可靠的处理。
曝光光源在375nm和405nm的波长谱中起作用。这有助于使用波长来模仿已知的良好过程配方(例如,遵循传统的汞灯频谱)或根据具体客户需求定制曝光的混合和匹配方法。
可以同时将两个波长施加到任何任意混合物,使得耐致力抗蚀剂图案化,包括正,负,可绘制的电介质,聚酰亚胺,干膜或甚至PCB材料。亚博网站下载还可以在高纵横比下支持厚的抗蚀剂曝光,例如晶片级包装,微流体,3D MEMS图案化和集成光子专用应用中常见的那些。
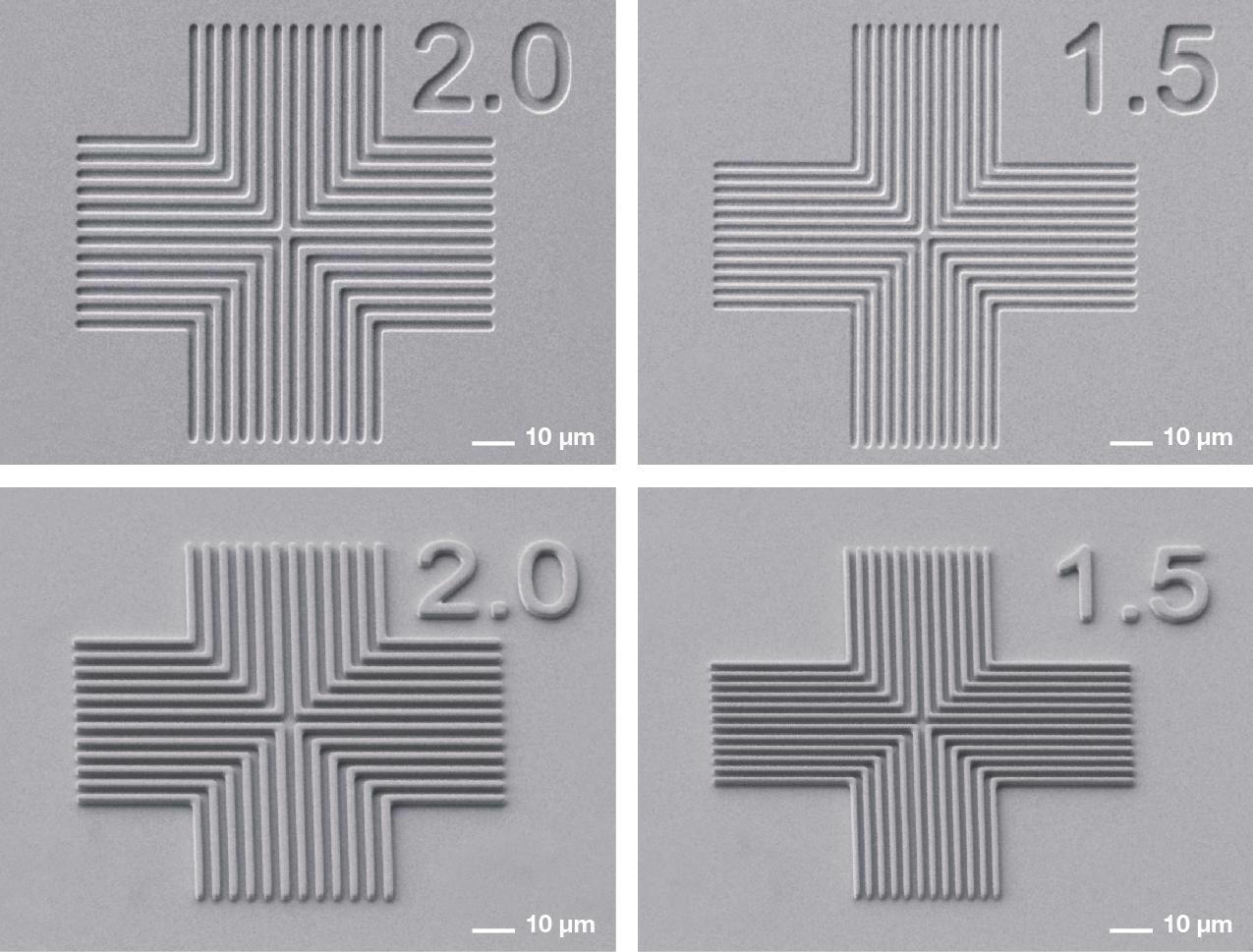
图5。SEM结果拼贴:线条空间分辨率测试1μm厚的正AZ MIR 701(顶部),线空间分辨率测试2μm厚阴性AZ NLOF(底部)。图片来源:EV Group
图5(顶部)包括许多SEM图像,显示1μm厚的正AZ miR 701抗蚀剂的标准线路空间分辨率目标。图5(底部)显示了2μm厚的负极抗蚀剂AZ NLOF的线空间分辨率测试。在每种情况下,通过额外的过程优化实现1.5μm的L / s结果。
这种优化涉及通过施加抗反射涂层或基材材料的改性来减少表面反射效应。
MLE™技术也可用于精细控制焦点(DOF),从而实现陡峭的侧壁,从而保持抗蚀剂的所需3D轮廓,防止边缘顶部或避免脚踏。与自动自适应聚焦相结合的显着工作距离有助于确保在曝光表面上进行图案化均匀性。
为了展示一系列线条和间距图案化性能,以及侧壁图案化质量,选择了用于细线和核线RDL创建的通常使用的TOK P-W1000T抗蚀剂。
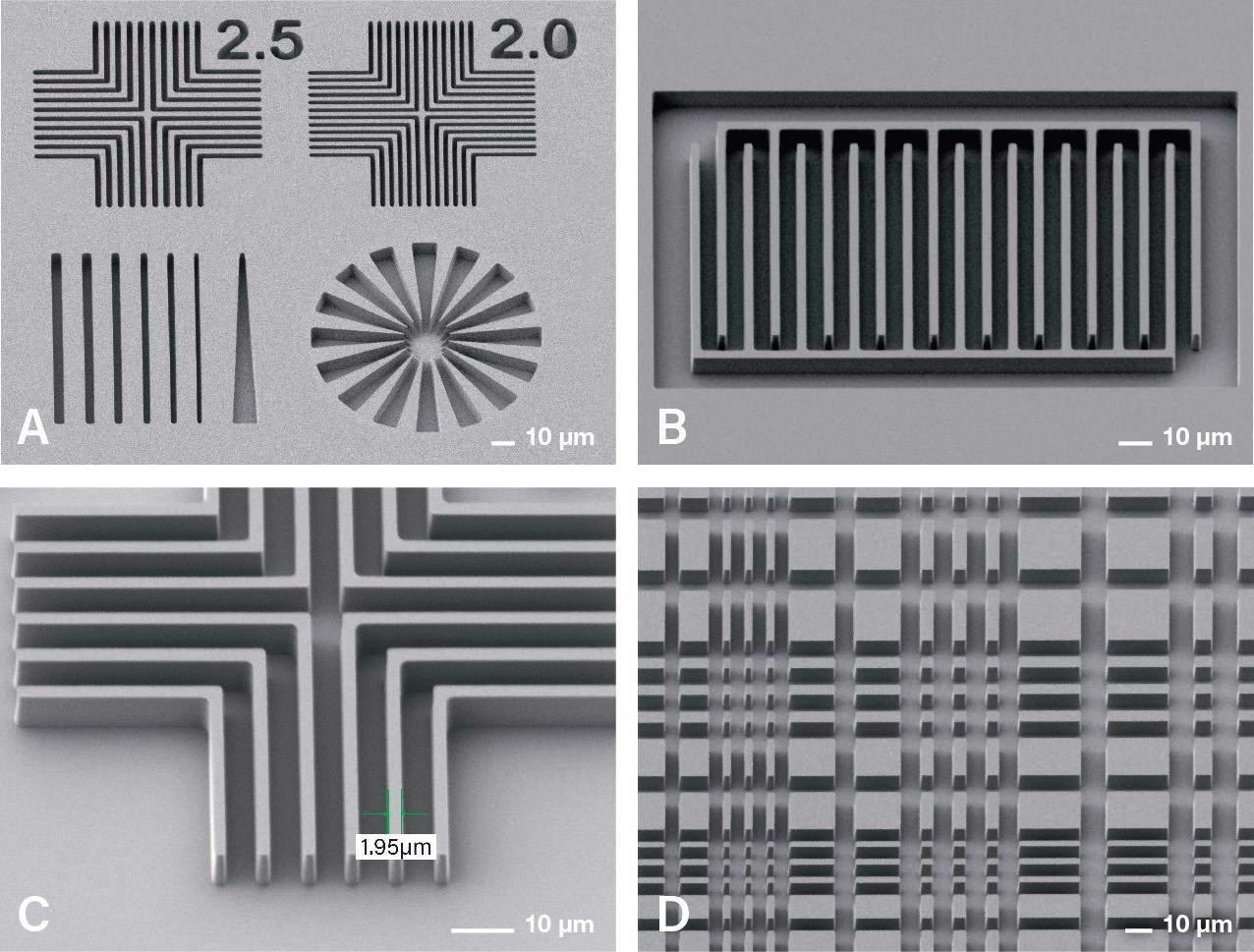
图6。基线评估(a)8μm厚的tok p-w1000t,(b)曲折,具有5μml/ s,(c)1:2间距变化,(d)水平和垂直方向的差异,具有比率1:1,1:2,1:3,1:4。图片来源:EV Group
图6显示了基线评估的SEM图像的许多示例,展示:
-
2μmL/ s分辨率靶向8μm膜厚度
-
5µm L/S分辨率,曲流模式
-
间距变化为1:2比例
-
L / S水平和垂直方向的变化,比率为1:1,1:2,1:3,1:4。
无掩模操作可扩展性
通过直接成像设备在研发期间实现的后端光刻结果历史上缺乏技术弹性,以适当地用坐垫的大容量制造(HVM)线。app亚博体育该行业正在看到一个不断扩展的产品组合 - 例如,小芯片和分段模具 - 这证明是持续性能缩放和越来越多的应用变异的驾驶员。
这些因素促使在各种抗蚀剂厚度和剂量水平上越来越需要动态图案化。MLE™可以提供2μm生产分辨率的高DOF,有效利用光学建立的物理衍射极限。
MLE™也具有高度可扩展的,其模块化系统根据用户通过添加UV曝光头来缩放(图7)。这有助于从R&D到HVM模式的快速过渡,有效地容纳通量优化,或适应不同的基板尺寸和材料。亚博网站下载MLE™非常适用于加工一系列从小硅或化合物半导体晶片的基板,直到面板尺寸。
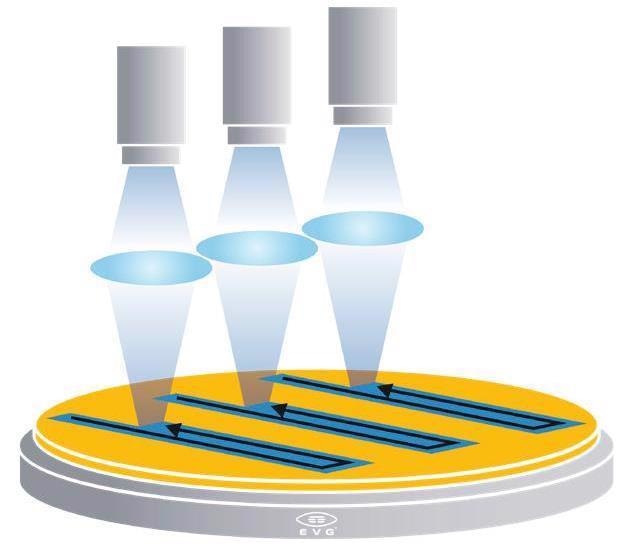
图7。MLE独特的集群曝光配置使曝光头易于添加,以调整不同的吞吐量需求和基片尺寸。图片来源:EV Group
概括
MLE™技术提供了一种新颖的探测方法,在吞吐量和格式方面提供智能和敏捷数字处理,提供可消费的基础设施和无掩模可扩展性。
无论光刻胶,MLE™都可以达到相同的高图案化性能。它由于灵活,可靠且可缩放的高功率UV激光源组合可以容纳多个波长选项,实现这一点。
该平台便于使用相同的光学对广泛的材料进行图形化;亚博网站下载例如,硅、玻璃、模具、聚合物和层压板。晶片夹头和自动聚焦系统可以补偿基片的弯曲和翘曲,这在FOWLP等应用中是一个特别重要的考虑因素。
该技术规范了几乎无限的设计灵活性,向新创新开辟了目前保守环境,帮助缩短了开发周期,并弥合研发和HVM之间的差距。
致谢
由Bozena Matusk亚博网站下载ova,BorisPovaïay,FrankBögelsack,罗马霍利,托比亚斯Zenger,Thomas Uhrmann和伯恩哈德·泰尔纳的材料生产
此信息已被源,审核和改编自EV集团提供的材料。亚博网站下载

EV组(EVG)是用于制造半导体,MEMS,复合半导体,电力装置和纳米技术装置的高批量生产设备和工艺解决方案的领先供应商。app亚博体育
A recognized market and technology leader in wafer-level bonding and lithography for advanced packaging and nanotechnology, EVG’s key products include wafer bonding, thin-wafer processing and lithography/nanoimprint lithography (NIL) equipment, photoresist coaters, as well as cleaning and inspection/metrology systems.
With state-of-the-art application labs and cleanrooms at its headquarters in Austria, as well as in the U.S. and Japan, EVG is focused on delivering superior process expertise to its global R&D and production customer and partner base – from the initial development through to the final integration at the customer’s site.
EVG服务成立于1980年,支持全球全球客户和合作伙伴的全球网络,拥有1000多名员工,在美国,日本,韩国,中国和台湾拥有1000多名员工。
有关此来源的更多信息,请访问电动汽车集团。