具有理想的机械、电气和光学特性的薄膜在现代生活中无处不在.这种先进的薄膜,特别是在具有复杂形状的小配件的沉积,是需要复杂的开发和验证活动具有挑战性的过程。

图片来源:TOFWERK
雇佣一个fibTOF二次离子质谱仪是对薄膜进行深度分析的有效手段。
该仪器能够提供有关层结构的元素组成的重要信息;例如,在表面和埋层(如附着力层)的化学均匀性的细节,污染物的检测(通常发现在两层之间的界面)和层间界面的清晰度。
而二次离子质谱法已被用于分析薄膜一段时间,1fibTOF通过提供高分辨率的化学图像和去除在分析前选择感兴趣元素的需要,发展了这种方法。
本文概述在无机薄膜测量的两个常见的例子使用fibTOF的。
例1:垂直腔面发射激光器
图1显示了垂直腔面发射激光器(VCSEL)的部分深度剖面。这是用外延结合AlGaInAs-InP的五个增益区域和几个交替GaAs-AlAs层的分布式布拉格反射器构建的。
这些器件的结构和操作的完整描述可在其他地方。2
图2显示了放大的铝深度剖面图像。这已经叠加在器件的结构上,以说明增益区域内的结构。
这一深度剖面是通过使用fibTOF仪器测量由Ga聚焦离子束显微镜产生的二次离子得到的+离子。该方法中使用由惠特等报道的VCSEL样品。3.
该方法成功地证明了深度分辨率优于8 nm,横向分辨率优于25 nm。值得注意的是,甚至可以检测到纳米厚度的更薄层,例如铬、钛或氧化钛的粘附层。

图1所示。利用Tofwerk的fibTOF和镓离子聚焦离子束显微镜,通过部分垂直腔表面发射激光器(VCSEL)获得深度剖面。为了获得最佳的深度分辨率,聚焦离子束的能量为3 keV。虽然镓峰出现,但可以清楚地看到半导体堆中的各个层+每个布拉格反射器对所述图像的右侧之间的信号是在溅射工艺的人工产物。x轴在FIB显微镜在选定区域的完成光栅给出注意,这是严格地正比于深度当且仅当溅射速率是恒定的(不太可能在通过不同材料的深度轮廓)和FIB射束的电流是恒定的。亚博网站下载图片来源:TOFWERK
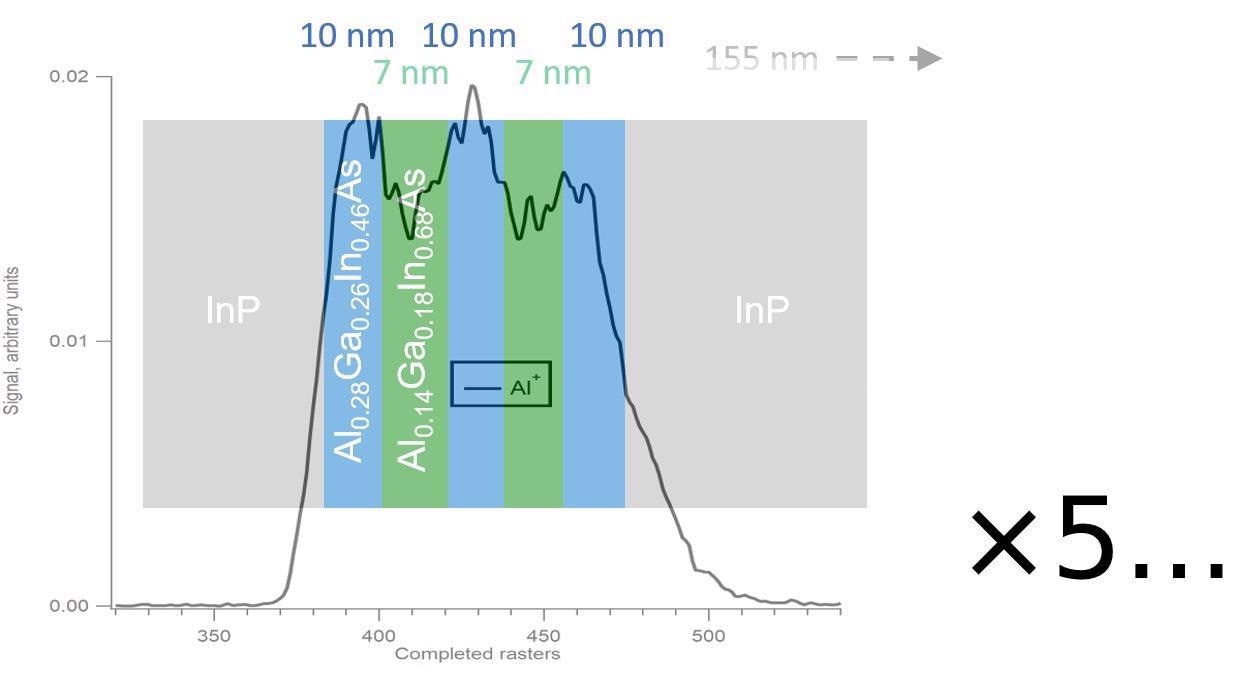
图2。放大部分Al+从图1(黑线)叠加在限定量子阱的VCSEL装置的增益区域内的薄膜层的示意图指示跟踪。有5个这样的区域(见图1),每个区域由3个以上的富铝层(蓝色表示)组成,每一个10 nm厚,由一个铝含量较少的层(绿色表示)的7 nm分隔。从fibTOF SIMS测量示出了迹线如预期中的铝浓度的三个峰。图片来源:TOFWERK
实施例2:确认粘接层的存在下,在薄膜叠层
这个例子锯测量使用收购fibTOF用于确定钽酸锂基板和金涂层之间的界面上是否存在钛和/或铂的粘附层。
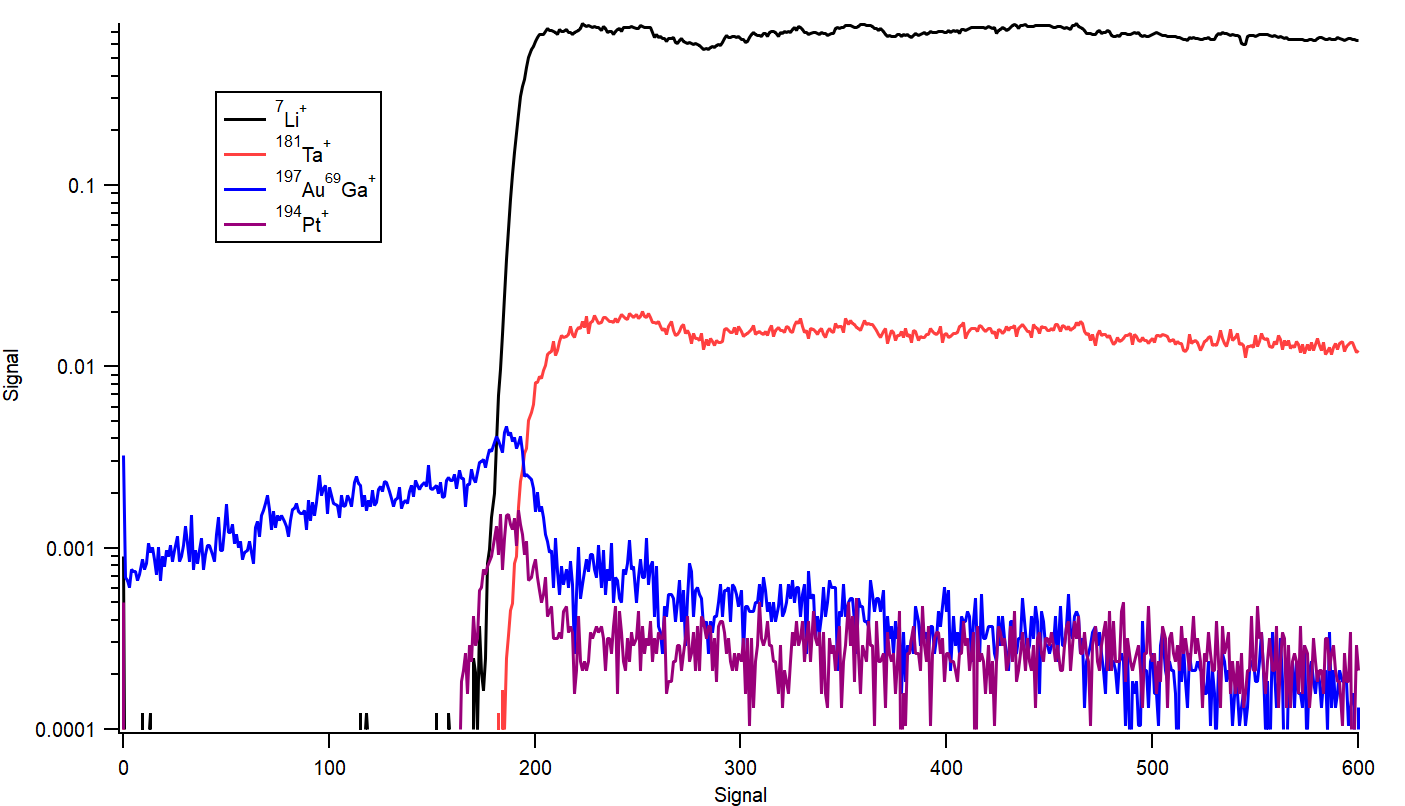
图3。金包覆钽酸锂的正二次离子深度剖面.图片来源:TOFWERK
这项研究确实证实了在金涂层和基材之间存在铂胶层。仪器无法完全分辨来自m/q 197的黄金信号,因为TaO的数量+而TaO的其他同位素含量太低,没有用处。
值得庆幸的是,有了关于样品组成的先验信息,就可以做出明确的解释。
虽然可取的是接近的质谱分析信息以开放的心态,它也是明智利用关于样品或在测量系统典型的污染物的任何细节的任何现有信息的。
该图还显示了另一种技术:利用GaPt的加合离子信号+.在这种材料中,该信号是较强的,并且因此所构成的等压比干扰在Pt的风险更小+离子信号。
为了保证最佳的深度剖面咨询
为了确保最佳的深度分辨率,聚焦的离子束应保持尽可能低的能量,同时确保光斑大小不会增加到降低形状质量的程度。
当从获得的数据生成深度剖面时,建议只利用坑中心的数据来调整感兴趣区域的侧面边缘。这有助于避免磨坑与倾斜的墙壁。
理想情况下,陨石坑的底部应该保持平坦,通常需要调整聚焦的离子束、扫描速率、像素大小或束电流。
在某些条件下,某些材料被聚焦的离子束碾磨后可能会变得粗糙或形成亚博网站下载波状表面。4导致深度分辨率下降。
这可以通过轻微改变阶段角度,调整光束条件,或通过使用辅助气体来解决,其中FIB-SEM仪器配备了气体注入系统。
如果需要更大的采样面积,建议在几个地方进行测量,以确保薄膜是均匀的;例如,在晶圆的中心和边缘,或靠近或远离ALD前驱体进口喷嘴。
薄膜分析的互补方法
可以同时使用许多互补的技术FIB-SIMS调查薄膜的组成和结构时。这些包括椭偏仪,X射线反射率,X射线荧光,或辉光放电谱 - 只要所述层保持均匀许多毫米的标度。
创建薄膜(机械地或使用FIB)的横截面可提供额外洞察分层结构。当与较厚的膜工作时,可以谨慎采用技术如EDX或(近场)拉曼显微镜,以获得约的结构和组成的信息。5
原子力显微镜也可以用来测量FIB凹坑的深度,提供在深度剖面中观察到的特征深度的准确信息。
参考文献
-
二级离子质谱深度分析。扫描3,1980.DOI: 10.1002 / sca.4950030202
-
表面发射激光器——它的诞生和光电子领域的新一代。IEEE j .选取。上面。定量。2000.DOI: 10.1109/2944.902168
-
惠特,等。高空间分辨率时间飞行二次离子质量为群众分析:原位AFM一种新颖的正交的ToF FIB-SIMS仪器。adv。垫。SCI。工程,2012.DOI:10.1155 /180437分之2012
-
谢诺伊;陈w·l·;金属表面溅射引起的复合调制波纹,理论物理。(1,2007年。DOI: 10.1103 / PhysRevLett.98.256101
-
Gucciardi, et al。近场拉曼光谱与成像。应用扫描探针方法,施普林格,柏林,海德堡,2006。DOI:10.1007 / 978-3-540-37316-2_10
确认
由TOFWERK的James亚博网站下载 Whitby和Lex Pillatsch原创的材料制作。

这些信息已从TOFWERK提供的材料中获取、审查和改编。亚博网站下载
有关此来源的更多信息,请访问TOFWERK。