化学机械抛光/平面化(CMP)是微电子工业中常用的一种方法,利用化学和机械的混合力来抛光表面。这种方法使用一种粗糙的腐蚀性泥浆来帮助晶圆片表面的平整。
这CMP浆料是纳米磨料颗粒和另外的化学物质的复杂组合,包括pH调节剂,表面活性剂,有机酸,络合剂和氧化剂。yabo214磨料的粒度分布是影响全过程的重要参数。磨料平均尺寸和分布宽度影响材料去除率(MRR)。
大颗粒计数(LPC)的发生可能通过产生划痕和缺陷来对产量产生有害影响1,2.LPCS是分布的右侧(更大的)尾和经常被称为如在计数/毫升> 1微米,然而,精确的尺寸范围相差应用中的颗粒浓度。
各种分析方法被用于衡量平均尺寸和尾巴。没有单独的仪器可以在整个动态范围内提供所有所需的数据。动态光散射(DLS)通常用来衡量平均尺寸并且采用测量LPC尾巴单粒子光学尺寸测定(SPOS)。
平均尺寸与尾巴
图1显示了CMP浆中使用的四种研磨剂的动态光散射计算的平均尺寸:二氧化硅,二氧化铈,氧化铝和胶体二氧化硅。在图1中也可以观察到平均尺寸和分布宽度的差异。

图1。分布的平均大小和尾部。图片信用:ENTEGRIS
显示的平均尺寸数据是使用Nicomp获得的®DLS系统。一份单独的Entegris应用笔记着重于测量CMP浆液的平均尺寸和ζ电位。3.尾巴4.使用单粒子光学尺寸测定的方法通常测量。
Accusizer中®实验室和在线系统由泥浆制造商,研究人员和全球Fabs使用。本文侧重于使用Accusizer Instruments系列的CMP浆液的实验室测量。在实验室中采用的模型来测量CMP浆液LPC,包括Accusizer AD,Accusizer AP和Accusizer FX Nano Systems。
Accusizer中,系统组件
所有Accusizer中系统由一个传感器,脉冲高度分析器(计数器),以及流体以稀释和运送样。所采用的信道1024是计数器相同的是,用于为每个系统和完成从传感器转化脉冲转换成颗粒大小和使用校准曲线计算的任务。两个传感器的机型,LE400和FX纳米,选择受样品的需求。
这LE400传感器,图2,测量为0.5-400μm,并记录通过系统的每个粒子,提供100%的计数效率。该传感器采用准直的激光束和光遮蔽和光散射检测器,以提供非常宽的动态范围。浓度阈值大约为10,000个颗粒/ ml。yabo214

图2。LE400传感器和操作。图片信用:ENTEGRIS
FX纳米传感器,图3,仅在流动池的中心处测量,采用聚焦激光束。该传感器需要专有的算法来转换由于聚焦光束和非独特的脉冲到粒度关系而导致尺寸的粒度。FX纳米传感器的尺寸低至0.15μm,可以测量更大的浓度(〜106颗粒/ ml)。yabo214FX纳米和LE400传感器的混合提供了0.15-400μm的动态范围

图3。FX纳米传感器。图片信用:ENTEGRIS
两个稀释流体的选择是提供给稀通过传感器的样品,对照流速和冲洗每次测量后以清洗系统。在此之后,软件评估了初始未稀释样品中的真实浓度随许多尺寸通道的用户确定。
Accusizer AD系统
accuizer AD系统是一种单级指数稀释系统,采用了LE 400传感器。在图4中可以看到原告和稀释流体图(不按比例)。
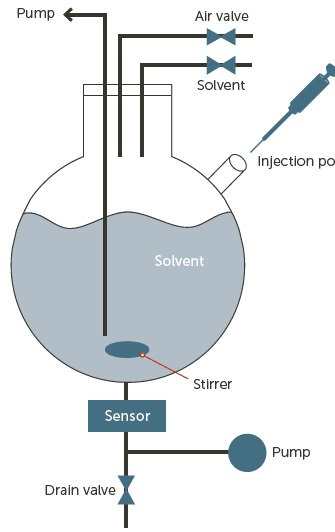
图4。Accusizer AD系统和稀释流体。图片信用:ENTEGRIS
稀释室被注入的样品和稀释即刻开始。溶剂(DI水),在相同的流速使样品通过传感器绘制被添加到腔室中。浓度观察到的,并且测量正式动工当浓度小于所述传感器的重合极限。系统自动刷新到测定结束以下的适当的背景水平。
Accusizer中APS系统
该系统结合了单级和两级稀释流体在一个系统。宾控器APS两级稀释流体图如图5所示。
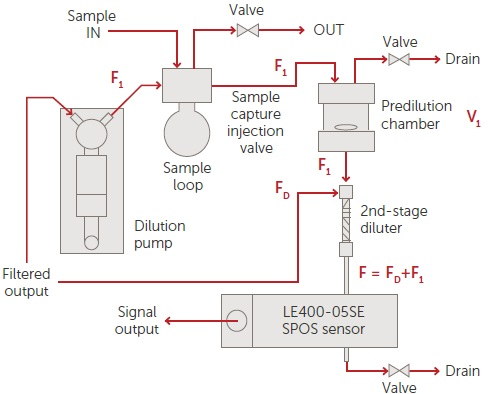
图5。Accusizer中APS两级稀释流体。图片信用:ENTEGRIS
accizer APS系统可以在多种模式下运行。在两级稀释中运行时,样品以体积V进入样品回路L..当样品环注入稀释室时,稀释的初始阶段开始于具有体积V的稀释室1.第一阶段的稀释阶段是v1/ V.L..当稀释后的样品流F1用过滤水˚F联合收割机D..整个流量F流过传感器进行分析。
该方法使得能够在整个测量期间稳定的浓度。为了更好地可视化自动稀释的这两种方法之间的区别 - Accusizer中AD与APS系统 - 计数对时间整个数据集合的对比度可以在图6a和6b可以看出。
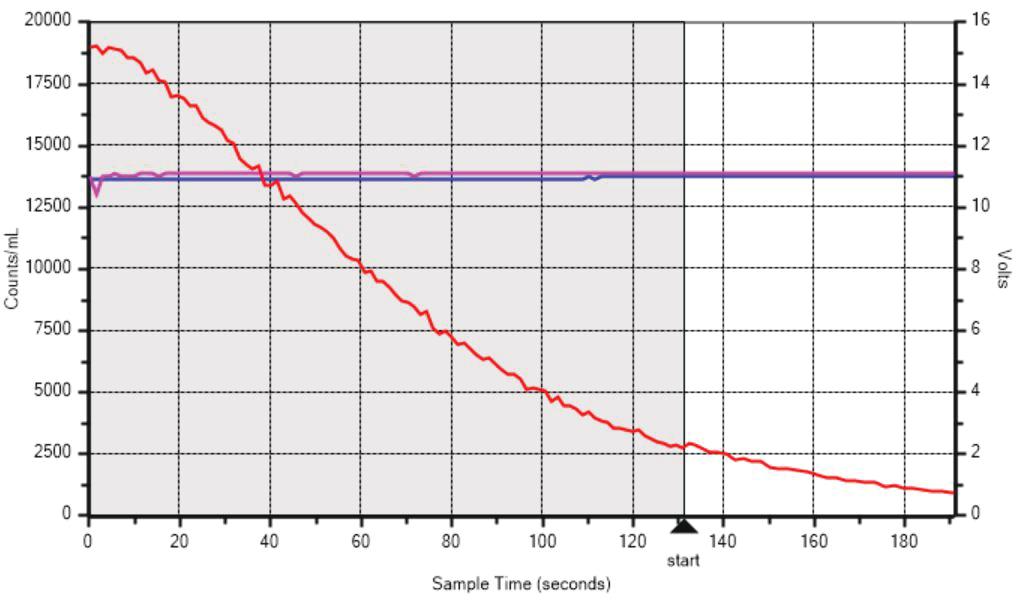
图6a。广告系统稀释。图片信用:ENTEGRIS

图6b。APS系统稀释。图片信用:ENTEGRIS
图解释
来源:entegris.
| . |
. |
| X轴 |
采样时间以秒为单位 |
| 左Y轴 |
粒子计数/ ml |
| 红线 |
计数/ mL相对时间 |
| 对Y轴 |
传感器电压 |
| 粉红色线 |
散射电压 |
| 蓝线 |
消光电压 |
| 灰色地带 |
稀释时间 |
| 白区 |
测量时间 |
图6a中的时间履历图表,是从Accusizer中AD系统上测量的浓缩二氧化铈浆料。的浓度(计数/毫升)开始极高一个在测量之前开始,在120秒时间稀释是必要的。同时样品仍在稀释测量然后发生。
图6b显示了二氧化硅CMP浆液的时间历程图,其中浓度在顺序开始时是令人满意的,但是直到30秒平衡时间后才进行测量。然后继续以稳定的计数/毫升的速率测量。这种方法适用于在LPC范围内计数率较小的样本,以便累计计数的总数在统计上对精确、可重复的结果是有效的。
Accusizer中,FX纳米系统
合并两个LE 400和FX纳米传感器,所述Accusizer中,FX纳米系统是单级指数稀释系统。稀释流体是类似于显示在图4和稀释需要的地方如在Accusizer中AD系统。将样品测量在三个集合创建。
该系统最初使用FX纳米传感器在低增益(.fyl)加上LE400范围(.led)积累数据。然后系统移动和测量FX纳米传感器在高增益(.fyh)。接下来,将收集这三个范围,并将这三个结果文件合并为包含整个动态范围的单个文件(.fyc)。
Accusizer中FX纳米系统非常适合在很宽的动态范围内提供灵敏度低至0.15μm。一些非常干净的硅胶浆进行了分析最好利用FX纳米系统,其中0.15微米的敏感度要收集足够的计数是有效的统计。此外,该系统内部采用内Entegris公司用于测试CMP浆料的过滤器固持。5.
结果
在通过Entegris PlanarCap之前和之后,使用Accusizer AD系统测量klebosol™1501胶体二氧化硅CMP浆料®NMB点式CMP浆液过滤器。在图7中可以看到上游和下游的比较结果。

图7。Accusizer中AD系统结果之前(红色)和之后(蓝色)过滤。图片信用:ENTEGRIS
此图显示LPCS的尖峰中心接近0.85微米将过滤过程中被除去。Accusizer中AD实验室系统可以被用于执行CMP浆料,其是传入的,并作为过滤研究,以确定最佳的可能的过滤器对于给定的浆料和方法需要的装置的QC检查。二氧化硅CMP浆料使用Accusizer中APS系统在两阶段的稀释方式工作的检查。
一个标准的结果在图8中,这是从在图6b中显示的运行时间数据的结果可以看出。图8中的表,在五个用户确定的尺寸范围表明颗粒浓度。此报告可以针对目前集中精力在范围内的结果视为跟踪LPCS至关重要。显示的浓度是稀释前的原始样品中的实际浓度。多达1024个大小渠道的综合表是可访问的,因为有很多的报表格式。
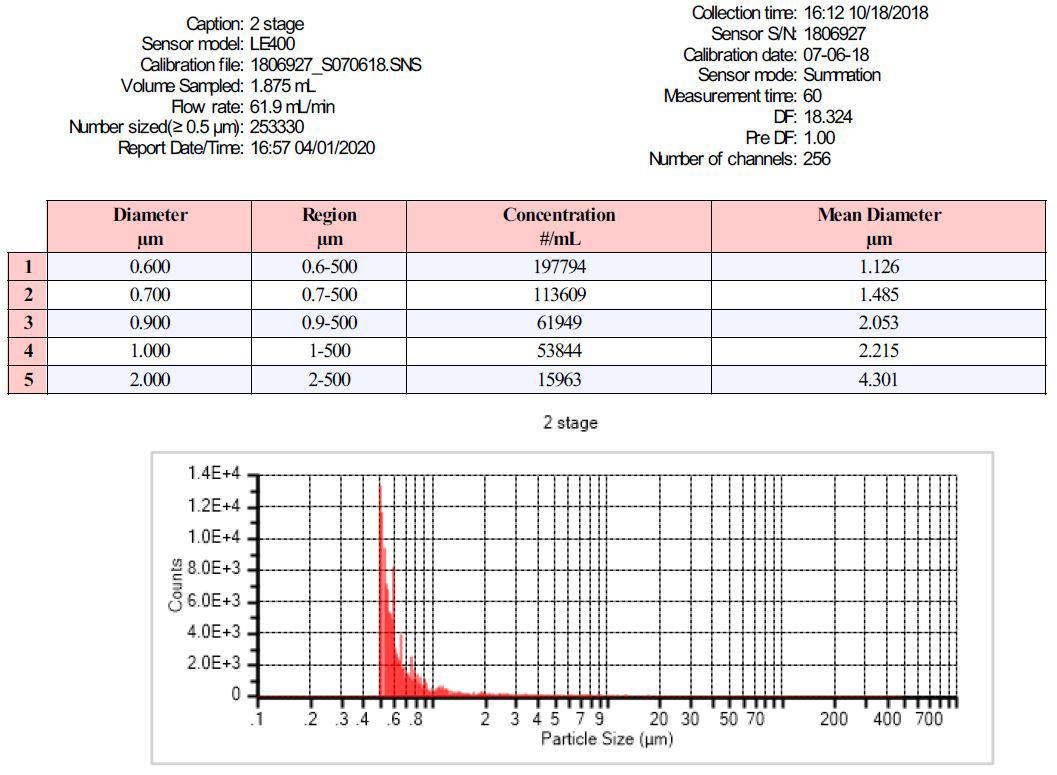
图8。CMP Accusizer中系统APS结果。图片信用:ENTEGRIS
一种双传感器Accusizer中FX纳米系统用于分析在内部entegris培训期间检查的氧化铝CMP浆液。在预稀1000:1之后,然后使用分散成11.8ml容器体积的0.5ml样品环分析样品。对于所有测量范围,60秒的采样时间产生平均每次分析的大约200,000个总颗粒。yabo214通过四个单独的Entegis现场应用工程师分析样品,并在图9中显示来自四个单独测量的结果,在对数刻度上展示的Y轴(浓度)。
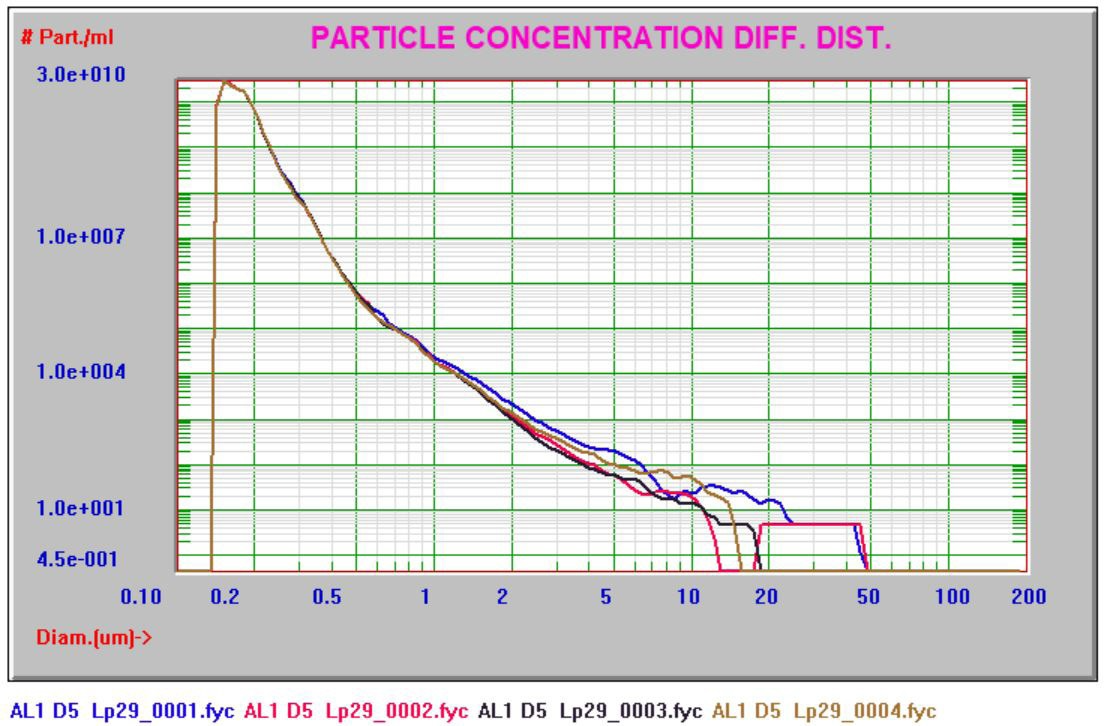
图9。氧化铝CMP浆料Accusizer中,FX纳米系统的结果。图片信用:ENTEGRIS
这些独立的结果具有良好的重现性。在1 μ m以下几乎不可能区分四个覆盖层。在10µm以上观察到的变化是由于大尺寸时统计值较差。由于这些是流体力学按照1000:1的预稀释和指数稀释计算出的实际样品浓度值,大于10µm的差异可能来自单个颗粒。yabo214
结论
各种令人责任的实验室粒度和计数分析仪非常适合于在CMP浆液中进行LPC测试。Accusizer系统的好处由复杂的汽车稀释流体,最大动态范围(0.15-400μm),高级报告可能性,以及CMP浆料生产商和FAB中最终用户的广泛批准。
Entegris建议将浆液样本发送到应用实验室进行评估和审查,因此可以建议使用特定浆料和客户需求的最佳系统设计。
参考
- 雷姆森,E。等人,在热解法二氧化硅浆料大颗粒计数的分析及其与通过CMP,杂志的电化学学会,153生成的划痕缺陷相关(5)G453-G461(2006)
- 金S.-K.等,的煅烧时间上合成二氧化铈粒子的用于浅沟槽隔离的化学机械平坦化工艺,杂志陶瓷加工研究,卷的物理性能的影响。yabo2147,第1号,第53-57页(2006)
- Entegris公司应用笔记 - 平均尺寸和CMP泥浆的Zeta电位
- Entegris公司应用笔记 - 检测尾巴在CMP泥浆
- Entegris应用说明- CMP浆液过滤器测试

这些信息已经从Entegris提供的材料中获得、审查和改编。亚博网站下载
有关此来源的更多信息,请访问Entegris公司。