结构化和非结构化的检验晶片在整个制造过程由光学检测系统MicroProf是允许的®DI。FRT的自动缺陷检测允许最大的质量。,从而可以提高工作效率,可以节省成本,避免进一步的处理有缺陷的晶片。
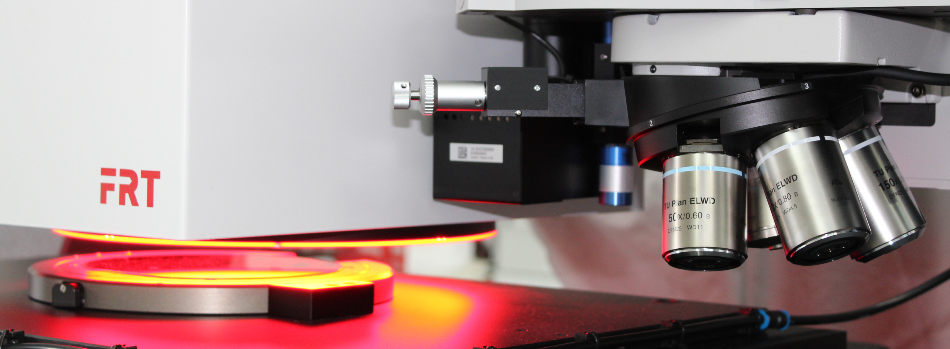
图片来源:FRT
智能缺陷分析
智能缺陷分析是基于先进的软件,使半导体制造商,以防止产量损失通过检测缺陷处于初期阶段。它监视检验结果数据,检测和分类的缺陷,如发现缺陷、划痕、污点和夹杂物在几秒钟内根据用户定义的标准。
它满足半导体晶圆厂的缺陷分析需求和供给用户提供多种功能检查和显示检查数据产生的MicroProf®迪,也可以管理的数据和分析。该软件还允许用户定义感兴趣的区域(roi)和分类缺陷位于这些区域。
Die-to-Die
die-based评估技术是用于结构化的晶片。“死死亡”评价技术,首次建立了一个ROI,用来创建“黄金形象”。
“黄金形象”是所有死亡的平均形象。接下来,“黄金形象”是离开各自的输入图像,以发现任何偏离平均死亡。
一个阈值方法是用来检测可能的缺陷,在输入图像和出口为KLARF格式。虽然这种方法有一个缺点,如果错误反复发生死亡,他们不认为是缺陷。
金色的死
“金死”评价技术可以使用为了避免这种情况,个人死在哪里与理想的死亡。然而,形状偏差可以导致一个不正确的“黄金形象”之间的对齐和各自的输入图像。这可能是由于轻微的旋转或转变之间的“黄金形象”和输入图像,所以非常精确的定位是至关重要的。
Blob分析
wafer-based评估技术是用于非结构化的晶片,基于像素灰度值通过blob的对比分析。首先,建立了晶片结构自动排除,那么缺陷进行检查。
缺陷检查软件
优化配方的软件允许用户收集数据为每个检查的步骤,确保加强过程控制。菜谱监控软件的内存和读取每个文件与检验结果写入文件夹。
接下来,分析结果的误差分布文件根据用户定义的标准,然后输出一个KLARF文件分类错误的签名。分析KLARF文件可能会被加载到检验结果数据库。
FRT缺陷检测的软件供应多功能处理,有效的可视化,和快速代晶片地图,除了精确的量化和理解文档的缺陷。
软件允许用户显示所选择的数据集的不同观点,例如晶片地图和缺陷列表与位置,大小,数量,和灰色的价值各自的缺陷。
软件提供了一个晶片地图揭示每个缺陷的位置选择数据集。根据用户定义的标准分配的缺陷和缺陷列表同步。
灵活的组合计量和检验在一个完全自动化的测量工具
在半导体行业,包装技术快速发展,实现速度、功能、形式因素所需的移动市场以其先进的电子产品。
晶圆级封装巨头()为高容量生产铺平道路(HVM)与3 d IC堆栈设备后身后。多个流程步骤意味着高水平的压力在晶片,这常常会导致质量问题。
为了确保产品质量和高产量,这些新的包装技术的复杂性和成本需要低成本在整个过程检验和计量解决方案。

图片来源:FRT
MicroProf®迪
的光学检查工具MicroProf®迪意味着现在可以检查结构化和非结构化晶片在整个制造过程。通过防止缺陷的进一步处理晶片,这提高了产量和节约成本。
高质量可以保证在整个晶片与MicroProf生产过程®DI。使用这种方法,MicroProf®DI定位,标识和分类缺陷最早阶段,所以提供了高质量的晶片和后芯片的基础。
创新的照明概念和模块化建筑说服
创新的照明MicroProf的概念®DI使许多缺陷类型可见和检测本地故障、夹杂物等缺陷,无论他们的立场。有效的过程控制MicroProf®迪有很多模块,可以灵活地在同一工具平台相结合,覆盖所有晶圆表面在高吞吐量。
模块包括:
- 光学检测和分类的缺陷模块通过单发和步骤
- 通过高精度显微镜检查的缺陷
- 综合多传感器与不同的地形和层厚度传感器计量
干涉层厚度传感器和红外光源和一个非接触式红外显微镜也可以,光学和非破坏性2 d分析隐藏的结构和内含物在晶片。
因为它是为了合并明视场之间的界限宏观检查和暗场微观检查,MicroProf®DI供应自动检查缺陷的质量控制方面,中期和后端在不同的照明技术。
二维成像技术允许快速和可靠的缺陷到千分尺检查范围。可选地,设置可以扩展使用高精度显微镜检查。
这提供了一种电动炮塔亮和暗视野检查,快速自动对焦,五个客观立场,微分干涉对比(DIC)和荧光显微镜(FL)。因此,检查的缺陷到sub-µm范围是可能的。
的MicroProf®DI为各种应用程序提供了测量解决方案结合计量和2 d检查,包括结构化和非结构化缺陷检验晶片和micro-bumps wafer-level计量,RDL、叠加,通过硅通过(TSV)在一个单一的测量工具。
适合每个HVM芯片厂
的MicroProf®DI提供高吞吐量和完全适合任何HVM芯片厂,设备内的晶片处理系统前端模块(EFEM),几乎不需维护的硬件组件。app亚博体育
系统可以配置为6,8”,和12“晶圆,两只或桥工具使两个晶圆片的处理大小在一个系统中。也可以配置为处理non-SEMI标准晶片,像高度扭曲的晶片(如eLWB),太鼓,晶片上胶带,保税晶圆、光和减少晶片,面板。
处理单元有一个单臂机器人末端执行器与两个负载端口映射器和射频识别阅读器等pre-aligner和OCR读者电台。的MicroProf®DI过滤器风扇单元(洁净),确保ISO 3班洁净室的状况的工具。
该工具配备了秒/宝石数据接口集成到车间自动化。然后,测量任务是由主机和测量结果自动转移到工厂控制系统。
MicroProf的好处®迪
的MicroProf®迪提供了一个可靠的平台技术,包括与一个无与伦比的高度灵活的软件的可用性水平。强大的软件缺陷数据转化为可行的快速过程控制,提高了分类和降低过程时间。
它允许用户开发和分析新工艺可靠,同时减少新产品的交货时间,直到市场同时启动。模块化的配置MicroProf®迪涵盖了完全不同的应用程序在芯片及晶片制造包括晶片资格,资格的过程,研究和开发和过程监控。
的MicroProf®DI符合行业要求的吞吐量、可靠性和准确性结合2 d和3 d技术来检测缺陷和测量功能,这对于当今先进的包装技术至关重要。以最高的质量,减少空间要求生产,减少处理时间,MicroProf®DI达到最高的客户满意度。

这些信息已经采购,审核并改编自FRT计量提供的材料。亚博网站下载
在这个来源的更多信息,请访问FRT计量。